集微網消息,臺媒報道稱,臺積電竹南先進封測廠 AP6 今年第三季起即將量產,除了既有的 2D / 2.5D 封裝外,也將進行大規模的 3D 封裝量產計劃,引發市場密切關注。
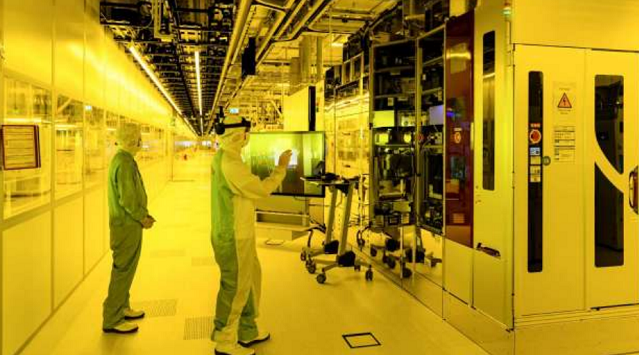
過去數年來,臺積電先進封裝技術不論是 InFO、CoWoS 業績皆穩健成長。其中,2.5D InFO 隨著蘋果 A 系列手機處理器銷量增加,成為臺積電先進封裝的主要營收來源,占比估計達 70% 左右。隨著 AI、HPC 應用興起,CoWoS 成長幅度更勝 InFO,加上先前耕耘的 TSV 技術,采用更厚銅的連接方式,讓 CoWoS 更具優勢,也獲 AMD 采用,帶動 CoWoS 占整體先進封裝營收比重攀升至 30%。
除此之外,臺積電繼續大力投資 2.5D / 3D 先進封裝技術開發,于 2020 年推出 3D Fabric 平臺,藉由 3D 封裝前段的硅堆疊與后端的先進封裝技術,強化架構彈性、提高效能、縮短上市時間與成本效益等,為因應未來需求,新建了竹南廠 AP6,主要就是提供 SoIC、WoW 技術。
據悉,臺積電計劃在 2022 年在先進封裝將達到五座廠生產。臺積電已將相關技術整合為“3DFabric”平臺,納入所有 3D 先進封裝技術包含 InFO 家族、CoWoS 等實現芯片堆疊解決方案。
目前業內期待臺積電今年 3D 封裝量產后的市場反應,如客戶群與應用擴充,首要瞄準對象就是既有客戶,不僅將現有產品從 2.5D 升級至 3D 封裝制程,也把更多產品從 2D 改為 2.5D 封裝。隨著眾多系統大廠紛紛加入自研芯片的行列,AP6 量產能否吸引實力更堅強的新客戶加入 3D 封裝行列也頗受關注。
特別提醒:本網信息來自于互聯網,目的在于傳遞更多信息,并不代表本網贊同其觀點。其原創性以及文中陳述文字和內容未經本站證實,對本文以及其中全部或者部分內容、文字的真實性、完整性、及時性本站不作任何保證或承諾,并請自行核實相關內容。本站不承擔此類作品侵權行為的直接責任及連帶責任。如若本網有任何內容侵犯您的權益,請及時聯系我們,本站將會在24小時內處理完畢。
 站長資訊網
站長資訊網